Fotorezysty. Pozytywny fotorezyst.
Naświetlanie odbywa się w zakresie widma ultrafioletowego (fotolitografia), wiązką elektronów (litografia wiązką elektronów) lub miękkim promieniowaniem rentgenowskim (litografia rentgenowska). Uderzenie albo niszczy polimer ( fotomaska dodatnia) lub odwrotnie, powoduje jego polimeryzację i zmniejsza jego rozpuszczalność w specjalnym rozpuszczalniku ( fotomaska negatywowa). Podczas późniejszej obróbki wytrawianie zachodzi w „oknach” utworzonych przez oświetlone (fotomaska dodatnia) lub nienaświetlone (fotomaska ujemna) obszary polimeru.
Rozdzielczość fotomaski definiuje się jako maksymalna ilość minimalna ilość elementów na jednostkę długości (1mm). R=L/2l, gdzie L jest długością przekroju, mm; l - szerokość elementu, mm. Rozdzielczość fotomaski pozytywowej uważana jest za wyższą, co przesądziło o jej szerszym zastosowaniu.
Istnieją dwa główne typy fotomasek stosowanych w produkcji płytek drukowanych: Suche fotomaska filmowa(SPF) i aerozol „POSITIV”. SPF stał się bardziej powszechny w produkcji, ponieważ zapewnia jednolitą warstwę. Jest to 3-warstwowa „kanapka” – dwie warstwy folii ochronnej, pomiędzy nimi znajduje się warstwa fotorezystu. Przykleja się go do obrabianego materiału za pomocą laminatora. Jednym z największych producentów filtrów SPF jest firma DuPont (USA). Produkujący filtry SPF pod nazwą handlową Riston, w rolkach po 152 m.
Typowe fotomaski
Jako fotomaski wrażliwe na światło widzialne często stosuje się:
- Pozytywny - sulfoestry diazydku ortonoftochinonu jako substancja światłoczuła oraz żywice nowolakowe, fenolowe lub krezolowo-formaldehydowe jako substancja błonotwórcza.
- Ujemne - kauczuki cykloolefinowe wykorzystujące diazydki jako środki sieciujące; warstwy alkoholu poliwinylowego z solami kwasu chromowego lub estrami kwasu cynamonowego; cynamonian poliwinylu.
Do pracy z dalekim promieniowaniem ultrafioletowym stosuje się:
- Pozytywny - uczulone polimetakrylany i arylosulfoestry za pomocą żywic fenolowych
- Negatywny - halogenowane polistyreny, diazydy z żywicami fenolowo-formaldehydowymi
Stosowane są także fotomaski z chemicznym wzmocnieniem obrazu ukrytego, składające się z światłoczułych soli oniowych i estrów żywic naftolowo-rezolowych, w których reakcje chemiczne zachodzą pod wpływem soli.
Do rejestracji przepływów elektronów, promieni rentgenowskich i jonów wykorzystuje się:
- Pozytywny - pochodne polimetakrylanów, ketonów polialkilenowych itp.
- Ujemne - polimery pochodnych metakrylanu, butadienu itp.
Literatura
- Fotolitografia i optyka, M. Berlin, 1974; Mazel E.Z., Press F.P., Planarna technologia urządzeń krzemowych, M., 1974
- W. Moreau. Mikrolitografia. W 2 częściach M., Mir, 1990.
- TSB, artykuł „Fotorezyst”
- Valiev K. A., Rakov A. A., Podstawy fizyczne litografia submikronowa w mikroelektronice, M., 1984;
- Światłoczułe materiały polimerowe, wyd. A. V. Eltsova, L., 1985. G. K. Selivanov.
Wyślij swoją dobrą pracę do bazy wiedzy jest prosta. Skorzystaj z poniższego formularza
Studenci, doktoranci, młodzi naukowcy, którzy wykorzystują bazę wiedzy w swoich studiach i pracy, będą Państwu bardzo wdzięczni.
Wysłany dnia http://www.allbest.ru/
Wstęp
Fotorezyst to polimerowy materiał światłoczuły. Nakłada się go na obrabiany materiał w procesie fotolitografii lub fotochemigrafii w celu uzyskania układu okien odpowiadającego fotomasce, umożliwiającego dostęp trawionych lub innych substancji do powierzchni obrabianego materiału.
Litografia jest jednym z głównych procesów wytwarzania półprzewodników, który polega na tworzeniu reliefu w warstwach dielektrycznych i metalowych osadzonych na powierzchni płytki półprzewodnikowej. Służy do selektywnego usuwania warstwy dwutlenku krzemu z tych obszarów płytek, w których mają powstać struktury dyfuzyjne.
Litografia polega na wykorzystaniu materiałów zwanych rezystami, które nakładane są na powierzchnię płyty w celu utworzenia maski – cienkiej folii ochronnej o pożądanej konfiguracji.
Fotomaski dzielą się na negatywowe i pozytywowe. Negatywy pod wpływem światła tworzą nierozpuszczalne obszary wzoru na powierzchni płyty i pozostają na jej powierzchni po wywołaniu. Natomiast fotomaski pozytywne tworzą rozpuszczalne obszary pod wpływem światła, a oryginalny wzór dokładnie powtarza się na powierzchni płytki. Wybór fotomaski zależy od użytego środka trawiącego i wymagań stawianych produktowi.
Dokładność rysunków fotolitograficznych mieści się w dziesiętnych częściach mikrona. Stawiają wysokie wymagania co do dokładności uzyskiwanych obrazów, a także jakości warstwy maskującej (brak przebić w fotomasce i odpowiednio dwutlenek krzemu).
Cel tej pracy: rozważenie i określenie zalet i wad różne rodzaje fotorezystu, a także wybrać najbardziej optymalny pod względem właściwości adhezyjnych, światłoczułości, rozdzielczości, odporności cieplnej i plazmowej oraz odporności na odczynniki chemiczne.
fotorezystywna powłoka narażona na działanie substancji chemicznych
1. Przegląd literatury
1.1 Badanie rodzajów fotomasek
Fotomaski (PR) są światłoczułymi i odpornymi na agresywne środowiska (kwasy, zasady) substancjami, zaprojektowanymi w celu stworzenia ochronnego reliefu o wymaganej konfiguracji przed późniejszą ekspozycją na środowiska chemiczne, fizyczne, elektrochemiczne i inne agresywne. Relief ochronny powstaje w wyniku tego, że pod wpływem światła padającego na określone obszary warstwy fotomaski, te ostatnie zmieniają swoje właściwości fizykochemiczne.
W zależności od mechanizmu reakcji zachodzących w fotomasce, cech i zmian jego właściwości, fotomaski dzielimy na negatywowe i pozytywowe. Podczas naświetlania fotomaski negatywowej przez fotomaskę (pozytyw) zachodzą w niej procesy prowadzące do utraty rozpuszczalności, a raczej polimeryzacji, w wyniku czego po obróbce w odpowiednich rozpuszczalnikach (wywoływaczach) zostają jedynie nienapromieniowane obszary znajdujące się pod nieprzezroczyste elementy fotomaski są usuwane, a na reliefie podłoża tworzy się warstwa ochronna, która powtarza negatyw obrazu szablonu zdjęcia.
Negatywne fotomaski mają na ogół wyższą przyczepność niż pozytywowe i są bardziej odporne na trawienie. Głównym składnikiem jest policynamonian winylu, który otrzymywany jest poprzez estryfikację polialkoholu winylowego.
Rysunek 1.1 – Wizualna zmiana właściwości fotomaski negatywowej po naświetleniu
W pozytywowych fotomaskach reakcje fotochemiczne zachodzą pod wpływem światła, co wręcz przeciwnie, prowadzi do zwiększonej rozpuszczalności w odpowiednich wywoływaczach. W efekcie usuwane są (wyprane) jedynie napromieniowane obszary fotomaski, a relief ochronny powtarza pozytywowy obraz fotomaski.
Takie fotomaski z reguły pozwalają na uzyskanie wyższych rozdzielczości niż negatywy, ale są droższe. Pozytywne fotomaski są najczęściej syntetyzowane na bazie diazydków naftochinonu.
Rysunek 1.2 – Wizualna zmiana właściwości fotomaski pozytywowej po naświetleniu
Jest ich też więcej nowy rodzaj fotomaski, takie jak odwracalne.
Odwracalne fotomaski to specjalne fotomaski, które po naświetleniu zachowują się jak pozytyw, ale można je „odwrócić” poprzez obróbkę cieplną i późniejsze wystawienie całego fotomaski (bez fotomaski) na promieniowanie ultrafioletowe. W takim przypadku po wywołaniu takie rezystory będą zachowywać się jak negatywne. Główną różnicą pomiędzy uzyskanymi w ten sposób wzorami a zwykłym użyciem pozytywowej maski jest nachylenie ścianek fotomaski; W przypadku fotomaski pozytywowej ścianki są nachylone na zewnątrz, co jest odpowiednie dla procesu trawienia, natomiast w przypadku odwrócenia wzoru fotorezystu ścianki są nachylone do wewnątrz, co jest zaletą w procesie litografii odwrotnej.
Do głównych zalet procesu fotolitograficznego zalicza się: możliwość uzyskania błonowych i wolumetrycznych elementów układów scalonych o bardzo małych rozmiarach (do ułamków mikrona) o niemal dowolnej konfiguracji; uniwersalność metody (wytwarzanie szablonów do osadzania folii i gridografii, selektywne trawienie warstw folii, trawienie „okienek” w warstwach tlenkowych do lokalnej dyfuzji, epitaksji i implantacji, głębokie trawienie w podłożach półprzewodnikowych i dielektrycznych itp.); możliwość zastosowania technologia grupowa(w jednej operacji i na jednym typie sprzętu można otrzymać setki i tysiące elementów scalonych i innych urządzeń).
Promieniowanie ultrafioletowe (UV) jest zwykle wykorzystywane do przeprowadzania procesów fotochemicznych w materiałach fotomaskowych. Ponieważ zawartość promieni UV w świetle naturalnym jest stosunkowo niewielka, w przypadku bardziej intensywnych procesów fotochemicznych wykorzystuje się sztuczne źródła promieniowania UV.
Absorpcja promieniowania UV przez cząsteczki organiczne zachodzi selektywnie, tj. W przypadku różnych substancji absorpcję obserwuje się przy bardzo określonej długości fali w zakresie UV.
1.2 Składy chemiczne i właściwości fotorezysty
Tak naprawdę wszystkie typy fotomasek pozytywowych to nic innego jak diazydek ortonaftochinonu (ONQD) i różnią się między sobą jedynie składem rozpuszczalników, ilością składnika światłoczułego i składem błonotwórczym.
Rysunek 1.3 - Wzór strukturalny pozytywowej fotomaski FP-RN-7
Problem tworzenia kompozycji światłoczułych na bazie ONCD polega na doborze składników światłoczułych i błonotwórczych, które zapewniają warstwie kopiowej dużą czułość całkową i widmową. Znacząca rozdzielczość małych elementów rastrowych i liniowych, a także niezbędna ciągłość filmu, przyczepność do podłoża płytowego, wytrzymałość mechaniczna i odporność chemiczna.
ONCD, jako związki oligomeryczne, mają zdolność tworzenia błon z roztworów w rozpuszczalnikach organicznych. Folie te mają jednak nierówną grubość i nie spełniają powyższych wymagań. Dlatego ONCD pełnią jedynie funkcje składników światłoczułych w kompozycjach.
Składniki błonotwórcze kompozycji dobiera się zgodnie z następującymi wymaganiami: dobra rozpuszczalność w rozpuszczalnikach dla ONCD; kompatybilność z ONCD w szerokim zakresie stężeń; łatwe usuwanie wraz z produktami fotolizy ONCD podczas wywoływania kopii.
Ostatni warunek ogranicza liczbę środków błonotwórczych jedynie do polimerów rozpuszczalnych w słabych roztworach alkalicznych. Powyższe wymagania w największym stopniu spełniają żywice fenolowo-formaldehydowe. Mają budowę liniową, dzięki czemu są termoplastyczne, dobrze rozpuszczają się w wielu rozpuszczalnikach i posiadają wysokie właściwości błonotwórcze. Badania żywic nowolakowych SF-010 (iditol), SF-012 (Novolak - 18) z ONHD wykazały, że po wprowadzeniu ich do roztworu kopiującego zmieniają się właściwości błonotwórcze roztworu, jednorodność i jednorodność filmów oraz kwasowość odporność ulega poprawie. Jednakże ze względu na rozpuszczalność żywic nowolakowych w roztworach alkalicznych warstwa kopiowa staje się bardzo wrażliwa na działanie wywoływacza i wartość pH roztworu wywołującego.
Jednym ze sposobów zwiększenia odporności chemicznej jest wprowadzenie dodatków zwiększających przyczepność i hydrofobowość folii. Powszechnie wiadomo, że żywice rezolowe fenolowo-formaldehydowe zawierają wiele wolnych grup metylolowych, co decyduje o ich dużej reaktywności. Przyczepność do metalu i tendencja do tworzenia trójwymiarowych struktur sieciowych w temperaturach powyżej 150°C . Wprowadzenie żywicy rezolowej SF-340A, lakieru bakelitowego i żywicy „101” znacznie zwiększa odporność chemiczną klisz światłoczułych, jednak ich zastosowanie jest ograniczone, ponieważ duże stężenia utrudniają wywoływanie kopii.
Folie wykonane z roztworów żywicy epoksydowej posiadają kompleks cennych właściwości. Wyróżniają się znaczną twardością, wyjątkową przyczepnością do metali, elastycznością, odpornością na warunki atmosferyczne, odpornością chemiczną, wysokimi właściwościami elektroizolacyjnymi i odpornością na znaczne wahania temperatury.
Największym zainteresowaniem cieszą się lakiery na bazie wysokocząsteczkowej żywicy epoksydowej E-05, lakier EP-527 i FL-5127, które posiadają wszystkie powyższe właściwości, ale nie wymagają wprowadzania utwardzacza do roztworu i rozpuszczania w etylowym cellosolwie . Praktyka potwierdziła możliwość wprowadzenia lakierów PL do kompozycji światłoczułej. Jednocześnie znacznie zwiększa się odporność chemiczna warstwy kopii i właściwości elektroizolacyjne, a wywoływalność kopii nie ulega pogorszeniu.
Interesujące są polimery o dużej masie cząsteczkowej, poliwinylobutyral i diflon. Poliwinylobutyral charakteryzuje się dobrymi właściwościami optycznymi (przezroczystość, bezbarwność, odporność na działanie światła) oraz wysoką przyczepnością do metali. W podwyższonych temperaturach poliwinylobutyral może oddziaływać ze składnikami rezolowymi warstwy kopiowej, znacznie zwiększając jej właściwości ochronne i hydrofobowość. Folie Diflon charakteryzują się wysoką przezroczystością optyczną, odpornością na promienie UV, niską higroskopijnością, podwyższoną odpornością na uderzenia i wytrzymałością na zginanie.
1.3 Podstawowe wymagania dotyczące fotomasek
Problem tworzenia fotomasek obejmuje, oprócz opracowania metod zwiększania światłoczułości polimerów, dobór i syntezę polimeru błonotwórczego i składników światłoczułych, opracowanie składów i określenie optymalnych warunków ich stosowania. Specyfika praktycznego zastosowania fotomasek określa listę wymagań dla nich, które muszą spełniać:
1) Wysoka zintegrowana światłoczułość i wymagana czułość widmowa;
2) Wysoka rozdzielczość;
3) Jednorodność na całej powierzchni, nieporowatość i stabilna w czasie warstwa fotomaski o wysokiej przyczepności do materiału podłoża;
4) Uzyskanie ostrej granicy pomiędzy obszarami chronionymi i niechronionymi fotomaską;
5) Odporność na atak chemiczny;
6) Brak zanieczyszczeń produktami przemian fotochemicznych fotomaski;
7) Dostępność materiałów, względna prostota, niezawodność i bezpieczeństwo użytkowania;
8) Dostępność określonych wywoływaczy i wytrawiaczy.
Wartość czułości widmowej fotomasek pozwala na rozsądny dobór źródeł promieniowania i racjonalny dobór warunków nieaktynicznego oświetlenia pomieszczenia do prac fotolitograficznych. Obecnie w produkcji urządzeń półprzewodnikowych szeroko stosuje się fotomaski dodatnie i ujemne. Fotomaski pozytywowe charakteryzują się dużą rozdzielczością i pozwalają na uzyskanie wyraźnych granic obrazu. Negatywy stosowane są głównie w procesach związanych z głębokim trawieniem metali oraz procesach galwanicznych. Ich bardzo cenną właściwością jest brak jonów metali alkalicznych podczas wywoływania, co jest szczególnie ważne w technologii półprzewodników. Łączne zastosowanie fotomaski negatywowej i pozytywowej ułatwia rejestrację i kontrolę w terenie oraz eliminuje operacje pośrednie podczas rejestracji.
Podstawowe wymagania dotyczące fotomasek wynikają z cechy technologiczne ich zastosowania.
Materiały światłoczułe muszą tworzyć jednorodne roztwory o danym stopniu lepkości, aby zapewnić równomierne nałożenie ciągłej cienkiej (0,3 - 0,6 mikrona) warstwy, która wystarczająco szybko schnie. Kompozycje fotorezystu nie powinny zawierać mechanicznie nierozpuszczonych wtrąceń (pyłu) o wielkości cząstek większych niż 0,1 - 0,2 mikrona, w przeciwnym razie cząstki te będą tworzyć przebicia w poddanej obróbce folii fotomaski.
Folie fotorezystu muszą charakteryzować się odpowiednio dużą przyczepnością do podłoża i odpornością na środki trawiące o różnym składzie, zachowując dobrą przyczepność podczas trawienia i zapewniając trawienie reliefu na wymaganą głębokość, zdeterminowaną procesem technologicznym wytwarzania głównego produktu. Fotomaski muszą zapewniać odpowiednio wysoką rozdzielczość, a także powtarzalny grawer reliefowy przy minimalnych wymiarach poprzecznych. Ponadto kompozycje fotorezystu podlegają wymogom dotyczącym stabilności ich właściwości w czasie i pomiędzy partiami.
Rozdzielczość powyższych fotomasek zależy od grubości warstwy i po zmniejszeniu do 0,2-0,3 mikrona może osiągnąć 1200-2000 linii/mm, co pozwala na fotochemigrafię struktur o szerokiej gamie konfiguracji z elementami konstrukcyjnymi o rozmiarach od do 1 mikrona lub mniej.
Obrazy utworzone na foliach fotorezystowych mają ostrzejsze krawędzie niż mogą zapewnić fotoemulsje o wysokiej rozdzielczości. Zjawisko to wynika z faktu, że fotomaski ze swojej natury mają raczej strukturę molekularną niż ziarnistą, co jest charakterystyczne dla wszystkich fotoemulsji na bazie związków halogenków srebra.
Należy jednak pamiętać, że rozdzielczość fotomaski określa się na wywołanym reliefie, a rozdzielczość całego procesu fotolitografii określa się po wytrawieniu błony na podłożu. Na rozdzielczość procesu duży wpływ mają zarówno warunki naświetlania (czas, oświetlenie), jak i jakość obróbki płytek po naświetleniu (czas wywoływania, kwasoodporność fotoreflektora, czas trawienia).
Kwasoodporność fotomaski oznacza odporność fotomaski na działanie środowiska agresywnego podczas wykonywania operacji trawienia, czyli podczas uzyskiwania reliefu na podłożu. W tym celu w fotolitografii na płytce półprzewodnikowej wykorzystuje się kwasy: azotowy, fluorowodorowy itp., a do produkcji fotomasek z reguły kwas solny.
Niewystarczająca kwasoodporność fotomaski objawia się następującymi objawami: fotomaska zostaje wytrawiona na krawędziach reliefu (co zmienia wymiary geometryczne wzoru), a także odrywa się od podłoża podczas trawienia lub ulega całkowitemu zniszczeniu (co powoduje całkowite gorszący).
1.4 Procesy zachodzące podczas narażenia
Fotomaski to fotorezystory wystawione na działanie światła (fotonów) w przeciwieństwie do fotomasek, które mają być wystawione na działanie elektronów. W tym drugim przypadku fotomaski nazywane są fotorezystami lub fotomaskami do litografii elektronicznej (wiązką elektronów). Fotomaski różnią się długością fali ekspozycji, na którą są wrażliwe. Najbardziej standardowe długości fal ekspozycji to tzw. linia i (365 nm), linia h (405 nm) i linia g (436 nm) widma emisyjnego par rtęci. Wiele fotomasek można również poddać działaniu szerokiego spektrum w zakresie UV (ekspozycja integralna), do czego zwykle używa się lampy rtęciowej. Odrębne klasy fotomasek obejmują materiały wrażliwe na głębokie promieniowanie UV (litografia GUV) i promieniowanie rentgenowskie (litografia rentgenowska). Ponadto istnieją specjalne fotomaski do litografii nanoimprint (nanodruk).
W fotolitografii precyzyjnej wolą stosować dodatnie układy fazowane ze względu na brak aureoli wzdłuż granic płaskorzeźby ochronnej. Pozytywne FR powstają w roztworach o właściwościach zasadowych (jako wywoływacz często stosuje się wodny roztwór fosforanu trójsodowego). Oprócz zniszczonych cząsteczek NCD wywoływacz musi także rozpuścić polimer, dlatego w celu ograniczenia ilości defektów w obszarach nienaświetlonych pożądane jest ograniczenie do minimum czasu ekspozycji wywoływacza na warstwę fotorezystu. Aby to zrobić, należy pracować przy dolnej granicy narażenia, która jest określona przez warunek osiągnięcia maksymalnej prędkości rozwoju narażonych obszarów zgodnie z krzywymi doświadczalnymi (ryc. 1.4).
1 - zależność szybkości rozwoju od narażenia; 2 - zależność błędu od narażenia Vpr=hc/tpr, gdzie tpr to czas całkowitego rozpuszczenia warstwy o grubości hc, która otrzymała dawkę promieniowania H = E?e; E - gęstość strumienia świetlnego, W/m2; ?e - czas ekspozycji, s.
Rysunek 1.4 - Krzywa charakterystyczna i błąd w odtwarzaniu wymiarów elementów po wywołaniu
Procesy zachodzące podczas narażenia na substancję dzieli się na trzy grupy:
1) Fotopolimeryzacja i tworzenie obszarów nierozpuszczalnych; najbardziej typowe dla układu, w którym stosuje się ten proces, są fotomaski negatywowe – estry kwasu cynamonowego i alkoholu poliwinylowego;
2) Sieciowanie polimerów liniowych rodnikami powstałymi podczas fotolizy związków światłoczułych, zastosowanie kauczuków z dodatkami substancji światłoczułych, np. bisazydkami, pozwala uzyskać wyjątkowo kwasoodporne fotomaski negatywowe;
3) Fotoliza związków światłoczułych z utworzeniem substancji rozpuszczalnych. Przykładem są najnowocześniejsze fotomaski, w których fotoliza związków zwanych diazydkami naftochinonu (NQD) powoduje, że napromieniowane obszary stają się rozpuszczalne w związkach alkalicznych.
1.5 Procesy rozwoju fotorezystu
Należy zauważyć, że podczas ekspozycji tylko część ONCD ulega zniszczeniu, a około 30% pozostaje niezmienione. Po wywołaniu w roztworze zasadowym zachodzi reakcja sprzęgania azowego pomiędzy oryginalnym ONCD i kwasem indenokarboksylowym, w wyniku której powstaje barwnik azowy, który prowadzi do zabarwienia oświetlonych obszarów kopii. Ogólnie proces wywoływania można sobie wyobrazić jako składający się z 4 etapów: zwilżanie powierzchni roztworem wywołującym; dyfuzja roztworu przez pory i pęknięcia warstwy, pęcznienie warstwy; osłabienie wiązania kleju i odklejenie folii od podłoża; mechaniczne usuwanie folii.
Ze względu na małą grubość warstwy kopiowej wszystkie te etapy przebiegają bardzo szybko. Zwilżanie jest pierwszą czynnością działania wywoływacza na naświetlaną warstwę. Dobre zwilżanie wynika z obecności w folii kwasów karboksylowych i nowolakowych żywic fenolowo-formaldehydowych. W miarę wnikania wywoływacza w podłoże błona pęcznieje, podczas czego tworzą się rozpuszczalne w wodzie sole kwasów karboksylowych, rozpuszcza się żywica nowolakowa, pomiędzy zniszczonymi i pierwotnymi składnikami diazowymi tworzą się rozpuszczalne w wodzie barwniki azowe, a folia zostaje zdyspergowana. fakt, że folia zawiera także składniki nierozpuszczalne w zasadach (żywice epoksydowe), nie powoduje całkowitego chemicznego rozpuszczenia folii. Na skutek odklejenia się folii od podłoża i rozpuszczenia poszczególnych składników, rozproszone cząstki usuwane są w sposób mechaniczny.
Zazwyczaj jako roztwory wywołujące stosuje się 2-5% roztwory fosforanu trójsodowego lub 1-2% roztwory krzemianu sodu. Można stosować 0,2-0,5% roztwory sody kaustycznej. Skład, stężenie i temperatura rozwijających się roztworów odgrywają niezwykle ważną rolę w procesie wywoływania. Choć głównym celem wywoływania jest usunięcie oświetlonych obszarów warstwy kopiowej, równie ważne jest, aby obszary nieoświetlone nie zmieniły swoich właściwości fizykochemicznych. A ponieważ folie zawierają rozpuszczalne w alkaliach żywice fenolowo-formaldehydowe, podczas wywoływania warstwa ulega częściowemu zniszczeniu w nieoświetlonych obszarach.Stopień tego zniszczenia zależy od powyższych parametrów roztworów wywołujących, a także od czasu (szybkości) manifestacji odporności na alkalia warstwy kopiującej.
Ostateczne ukształtowanie się obrazu elementów obwodów w folii fotomaski następuje po potraktowaniu naświetlonych powłok odpowiednimi roztworami i odpowiednim usunięciu obszarów napromieniowanych (w przypadku kompozycji pozytywowych) lub nienapromieniowanych (w przypadku negatywów). Istnieją dość wyraźne różnice w manifestacji fotomasek negatywowych i pozytywowych, które są określone przez charakter chemiczny materiałów polimerowych tworzących fotomaskę oraz rodzaj fotorezystu. reakcje chemiczne. Wszystkie fotomaski negatywowe charakteryzują się procesami fotochemicznego sieciowania i wykorzystaniem w procesach wywoływania rozpuszczalników organicznych. Proces manifestowania się związków ujemnych jest typowym fizycznym i chemicznym procesem rozpuszczania polimeru.
W przypadku istniejących fotomasek pozytywowych proces wywoływania jest bardziej złożony i opiera się na oddziaływaniu chemicznym produktów fotolizy diazydków o-naftochinonu i żywic fenolowych ze związkami alkalicznymi i późniejszym fizykochemicznym usuwaniu produktów reakcji.
Rozwój fotomasek negatywowych. Równolegle z wywoływaniem, a następnie myciem i suszeniem negatywowych fotomasek zachodzą następujące procesy:
1) Dyfuzja cząsteczek wywoływacza do napromieniowanych i nienapromieniowanych części błony fotorezystowej;
2) Obrzęk napromieniowanych i nienapromieniowanych obszarów folii;
3) Rozpuszczenie nienapromieniowanych obszarów folii i przejście cząsteczek polimeru do masy rozpuszczalnika;
4) Tworzenie konfiguracji elementów;
5) Oczyszczenie nienapromieniowanych obszarów powierzchni z pozostałości fotomaski;
6) Odparowanie rozpuszczalnika z objętości napromieniowanych obszarów folii fotomaski i powrót do jej pierwotnych wymiarów geometrycznych.
Napromieniowane obszary folii fotomaski (w zależności od dawki napromieniania) mogą zawierać usieciowane makrostruktury, pojedyncze cząsteczki polimeru oraz układy rozgałęzione. Wywoływacz do negatywowych fotomasek musi charakteryzować się z jednej strony dobrą zdolnością rozpuszczania w stosunku do polimeru pierwotnego, a z drugiej strony minimalnym wpływem na napromieniane obszary błony. Wywoływacz powinien powodować minimalne pęcznienie napromienianych obszarów, a co za tym idzie, minimalne zniekształcenie wymiarów geometrycznych. Pęcznienie napromienianych obszarów zależy głównie od liczby utworzonych wiązań poprzecznych i właściwości usieciowanego polimeru. Przy niewystarczającej ekspozycji napromieniowane obszary albo całkowicie się rozpuszczą, albo pęcznieją do tego stopnia, że folia może odkleić się od powierzchni podłoża, albo zwiększą swoją objętość tak bardzo, że sąsiednie elementy obwodu zostaną ze sobą połączone. Dlatego w przypadku fotorezystu negatywowego o właściwym doborze naświetlenia decyduje nie tylko uzyskanie określonej geometrii elementów, ale także spęcznienie napromienianych obszarów fotorezystu.
W przypadku fotomasek negatywowych naświetlonych w optymalnych trybach nadmierne wywołanie nie jest niebezpieczne, dlatego procesy wywoływania tych kompozycji są po prostu zautomatyzowane. Fotorezysty można wywołać w warunkach statycznych lub przez natryskiwanie cieczy. Przy pewnych minimalnych rozmiarach elementów obrazu i odległościach między nimi wywoływanie staje się bardzo utrudnione ze względu na niemożność usunięcia nienaświetlonego polimeru z przestrzeni pomiędzy elementami.
Rozwój fotomasek pozytywowych. Jak już wspomniano, powstawanie napromieniowanych obszarów fotomasek pozytywowych na bazie diazydków naftochinonu ma charakter chemiczny:
Rysunek 1.5 - Charakter chemiczny diazydków naftochinonu
Powstała sól kwasu indenokarboksylowego jest rozpuszczalna w wodzie i podczas wywoływania ulega rozpuszczeniu. Ponadto folia fotomaski zawiera żywice fenolowe, które są rozpuszczalne również w roztworach wodno-alkalicznych. Cechą szczególną rozwoju pozytywowych fotomasek jest prawie całkowity brak pęcznienia obszarów nienapromieniowanych, dlatego rozdzielczość pozytywowych fotomasek zależy w mniejszym stopniu od grubości powłoki.
Inną cechą rozwoju pozytywowych fotomasek jest ich wrażliwość na nadmierne wywołanie, czyli zbyt długie przebywanie błony fotorezystu w wywoływaczu. Im większa jest szybkość rozpuszczania napromieniowanych obszarów folii V0 i jednocześnie mniejsza szybkość rozpuszczania nienapromieniowanych obszarów Vn, tym bardziej selektywny jest wywoływacz. Wprowadzenie środków powierzchniowo czynnych do wywoływacza zmniejsza jego napięcie powierzchniowe, zwiększa zwilżalność fotomaski i sprzyja lepszemu skuteczne usuwanie napromienianych obszarach i zmniejszenie klina manifestacyjnego.
Stabilność wymiarów geometrycznych elementów podczas przebudowy zależy od wielu czynników, z których główne to: a) struktura chemiczna fotomaski; b) stężenie wywoływacza i temperatura; c) jakość folii fotomaski i jej przyczepność do powierzchni podłoża, a co za tym idzie, sposoby tworzenia i suszenia folii fotomaski; d) czas ekspozycji; e) okres indukcji i szybkość rozpuszczania nienapromieniowanych odcinków folii.
Miejsca, w których ugięte światło wchodzi w geometryczny obszar cienia, można uznać za obszary o zwiększonej szybkości rozpuszczania nienapromieniowanej warstwy. Stabilna i powtarzalna realizacja ukrytego obrazu elementów powstałych podczas naświetlania jest możliwa jedynie poprzez optymalizację wszystkich sposobów tworzenia błony fotorezystowej i zastosowanie błon fotorezystowych, które charakteryzują się maksymalną selektywnością przy ekspozycji na wywoływacz na obszarach napromieniowanych i nienapromieniowanych.
1.6 Metody wytwarzania powłok fotomaskowych
O właściwościach folii fotorezystowych decyduje nie tylko skład zastosowanych kompozycji światłoczułych, ale także sposób ich wytwarzania. Na operacje nakładania folii fotomaskowych nakładane są następujące wymagania:
1) Możliwość formowania pozbawionych defektów folii o kontrolowanej i powtarzalnej grubości;
2) Realizacja szerokiego zakresu grubości powłok;
3) Tworzenie folii o dużej jednorodności grubości;
4) Maksymalnie wysoka przyczepność do podłoża.
Istnieje kilka metod formowania folii fotorezystowych: powlekanie wirowe, napylanie katodowe, zanurzanie (zanurzanie), zalewanie, walcowanie.
Powłoka wirowa jest obecnie jedną z najpowszechniejszych metod powlekania fotorezystu, szczególnie w zastosowaniach, w których cienka warstwa fotorezystu jest nakładana na podłoże z jednej strony. Zaletą tej metody jest możliwość nałożenia fotorezystu na małe obszary powierzchni przy dużym stopniu równomierności grubości. Fotomaski przed nałożeniem na podłoże należy oczyścić z zanieczyszczeń mechanicznych. Najprostszą metodą czyszczenia jest filtracja. Tworzenie powłok poprzez wirowanie zwykle prowadzi się przy prędkości obrotowej rotora w zakresie 2-10 tys. obr/min; Niższe prędkości obrotowe prowadzą do powstania ściegu fotorezystu generowanego przez napięcie powierzchniowe roztworu wzdłuż obwodu podłoża. Dla danego stężenia fotomaski istnieje pewna prędkość krytyczna, której przekroczenie nie powoduje zmniejszenia grubości warstwy. Moment ten odpowiada równowadze sił kohezji i odśrodkowych.
Nierówność grubości powłoki na powierzchni płyty w dużej mierze zależy od prędkości obrotowej wirnika. Zatem przy prędkości wirnika 70-80 obr/min rozrzut wynosi 3-40% (ryc. 6.4 a, b), dla wirówek wysokoobrotowych waha się od 5-14%.
Najbardziej elastyczną metodą jest natryskiwanie (proszkowanie). ostatnie lata zaczyna znajdować praktyczne zastosowanie. Istota metody polega na rozproszeniu fotomaski za pomocą sprężonego gazu (powietrza) i nałożeniu jej na płytkę w postaci drobnego aerozolu.
Do głównych zalet tej metody należy możliwość formowania powłok w szerokim zakresie grubości z dość dużą powtarzalnością i niewielkim rozrzutem grubości (±15-20%), brak zgrubień na krawędziach blachy, możliwość nakładanie warstwy fotorezystu na profilowane powierzchnie, wysoka produktywność i możliwość automatyzacji procesu.
a - wirowanie (78 obr./min); b - wirowanie (300 obr./min); c - opryskiwanie; g - wypełnienie; d - zanurzenie; e - radełkowanie
Rysunek 1.6 - Rozrzut grubości folii fotomaski dla różnych metod formowania
Metoda zanurzeniowa jest szczególnie wygodna w przypadku formowania powłok dwustronnych. Przekrój Powłoka zanurzeniowa ma kształt klina. Ponieważ prędkość wyciągania płytki fotorezystowej jest odwrotnie proporcjonalna do grubości powłoki, wolniejsze rozciąganie daje cieńszą i ogólnie bardziej jednolitą powłokę.
Wypełnianie polega na nałożeniu dawki fotorezystu na powierzchnię podłoża. Podłoże obraca się naprzemiennie w kilku kierunkach w celu rozprowadzenia fotomaski i jego wysuszenia. Głównymi wadami tej metody są niejednorodność powłoki i duża zmienność grubości (30-40%). Walcowanie to metoda nakładania powłoki fotorezystowej o wysokim stopniu jednorodności na sztywne podłoża. Odmianą tej metody jest nakładanie na podłoża fotomaski filmowej (suchej) wstępnie uformowanej na pośredniej bazie polimerowej.
Tabela 1 - Porównanie właściwości fotomasek pozytywowych i negatywowych
|
Porównywalne cechy |
Fotorezyst |
||
|
Negatywny |
Pozytywny |
||
|
Efekt ekspozycji |
Wystarczająca polimeryzacja do utworzenia wzoru |
Odporność chemiczna maski tworzącej wzór; zmiany chemiczne zachodzą w obszarach niezwiązanych z tworzeniem wzoru maski. |
|
|
Wrażliwość na tlen |
Wrażliwy, co utrudnia ekspozycję |
Niewrażliwy |
|
|
Usuwanie oporu |
Trudny do usunięcia, obecny materiał coc ma wysoką względną masę cząsteczkową |
Łatwy do usunięcia, ponieważ nie zawiera składników o dużej względnej masie cząsteczkowej |
|
|
Odporność chemiczna |
Słaba odporność chemiczna, niski współczynnik filtracji |
Wysoka odporność chemiczna i szybkość filtracji |
|
|
Manifestacja |
Wywoływaczem jest rozpuszczalnik organiczny; wzór pęcznieje; utylizacja śmieci jest trudna |
Wywoływacz na bazie wody: wzór nie jest zakłócany; utylizacja śmieci jest prosta |
|
|
Grubość FR |
Nie powinna przekraczać 1/3 minimalnego rozmiaru obrazu |
Może być równy lub większy od minimalnego rozmiaru obrazu |
|
|
Powłoka FR stopni reliefowych |
Słabe ze względu na ograniczenia grubości powłoki |
Znakomity, ponieważ można zastosować stosunkowo grubą powłokę (2-3 mhm) |
Do stworzenia konfiguracji elementów folii w procesie fotolitografii wykorzystuje się selektywne trawienie struktur wielowarstwowych osadzanych w jednym cyklu technologicznym osadzania próżniowego. Na podłoże natryskiwana jest kolejno folia rezystancyjna, następnie folia przewodząca i w razie potrzeby warstwa na pola kontaktowe.
Następnie wielowarstwową strukturę poddaje się fotolitografii na każdej warstwie lub na grupie warstw, uzyskując w ten sposób konfigurację cienkowarstwowych rezystorów i przewodników.
Aby usunąć resztki rozpuszczalnika z folii fotorezystu, przeprowadza się suszenie, podczas którego zwiększa się przyczepność pomiędzy podłożem a fotomaską. W folii fotorezystu w wyniku naświetlania powstaje konfiguracja, podczas której obraz z fotomaski przenoszony jest na powierzchnię podłoża pokrytego warstwą fotorezystu.
Uszkodzenie warstwy fotomaski, łuszczenie się, wskazuje na nieodpowiednie jednoczesne stosowanie wytrawiacza i fotomaski. Należy również unikać długotrwałego narażenia fotomaski na działanie środka trawiącego.
Wniosek: Porównanie charakterystyk przedstawionych w tabeli 1 wyjaśnia zalety dodatnich przesuwników fazowych, które są coraz częściej stosowane w technologii układów scalonych ze względu na ich wyższą rozdzielczość.
2. Część teoretyczna
2.1 Wybór bardziej zaawansowanej technologicznie fotomaski
Wszystkie powyższe polimery i oligomery spełniają wymagania dotyczące składników błonotwórczych kompozycji. Jednakże ze względu na zwiększoną odporność na alkalia są to dodatki wymienne, wprowadzane do roztworu światłoczułego w ograniczonych ilościach w celu poprawy właściwości technologicznych warstwy kopiowej. Głównymi składnikami znanych rozwiązań krajowych i zagranicznych są światłoczułe ONCD i błonotwórcze żywice nowolakowe. Ogólnie stosunek stężeń składników światłoczułych i wszystkich składników błonotwórczych wynosi od 1:1,25 do 1:2,5. Zatem roztwory światłoczułe na bazie ONCD są wieloskładnikowymi układami monomer-polimer, których składniki niosą wyraźny, funkcjonalny ładunek - z jednej strony są ze sobą powiązane i dopiero w połączeniu zapewniają niezbędne parametry warstw światłoczułych .
Cynaniany poliwinylu są wrażliwe na widmo ultrafioletowe o długości fali 330 nm i mniejszej, ale za pomocą specjalnych sensybilizatorów granicę czułości można znacznie przesunąć do zakresu fal długich widma do 450 nm. Pozytywne fotomaski mają granicę czułości dla długich fal w zakresie 460-480 nm, co eliminuje szereg wymagań dotyczących materiałów przezroczystych przy projektowaniu sprzętu do naświetlania. W szczególności do naświetlania pozytywowej fotomaski można zastosować konwencjonalną optykę zamiast kwarcu. Ta okoliczność sprawia, że fotomaska pozytywowa jest wygodniejsza w druku projekcyjnym.
Fotorezystory przetwarzane w celu usunięcia obszarów wystawionych na działanie światła nazywane są fotorezystorami pozytywowymi, ponieważ pozostawiają obszary pod powłoką ochronną, która osłabia działanie światła. Pozytywny fotorezyst powinien składać się z błonotwórczej żywicy fenolowo-formaldehydowej zmieszanej ze związkiem diazydku naftochinonu, który jest składnikiem światłoczułym. Eliminacja azotu, której towarzyszy przegrupowanie pierścienia i reakcja ze śladowymi ilościami wody obecnej w atmosferze lub samej folii, prowadzi do powstania kwasu indenokarboksylowego
W przypadku kompozycji negatywowych początkowy moment pojawienia się fotoreliefu – pojawienie się na podłożu nierozpuszczalnej w roztworze wywołującym błony o minimalnej grubości 0,03 mikrona – określa próg czułości kompozycji. Często światłoczułość ocenia się również na podstawie grubości warstwy roboczej, zwykle 0,5 µm. Miarą intensywności procesu jest współczynnik kontrastu - tangens kąta nachylenia prostego odcinka krzywej charakterystycznej (może przyjmować wartości od jednostek do kilkudziesięciu jednostek). Technikę tę opracowano w celu określenia czułości całkowej i widmowej fotomasek negatywowych i pozytywowych. Na jego podstawie uzyskuje się szereg parametrów charakteryzujących fototropizm warstwy. Podstawione kwasy indenokarboksylowe powstałe podczas fotolizy diazydków chinonu są zdolne do dekarboksylacji po podgrzaniu, a odcinki warstwy z wprowadzonymi do niej pochodnymi indenu tracą zdolność rozpuszczania się w zasadach. Stwarza to możliwość odwrócenia materiału – przekształcenia warstwy dodatniej w ujemną. Modyfikacja obróbki dodatniej warstwy oporowej chioidiazydowej w celu wytworzenia negatywu pozwala uzyskać lepsza rozdzielczość oraz mniejszą liczbę defektów w negatywie niż w przypadku warstwy opartej na rezystorach samoujemnych. Ponadto fotomaski dodatnie są mniej wrażliwe na tlen niż fotomaski ujemne, co upraszcza technologię. Wreszcie, zastosowanie systemu odwracalnego eliminuje potrzebę posiadania zapasu odczynników i materiałów do kompozycji negatywowych i pozytywowych, które różnią się materiałami i obróbką.
Zalety fotomasek pozytywowych:
Pod względem przyczepności i rozdzielczości pozytywne fotomaski są lepsze od negatywnych, ale są droższe i zawierają toksyczne rozpuszczalniki. Rozdzielczość rezystorów dodatnich wynosi 350 linii/mm. Główną zaletą fotomaski pozytywowej jest brak garbowania podczas przechowywania detali z nałożoną warstwą światłoczułą.
2.2 Badania fotomasek IX420N-32SR, IX420N-19SR i EPG 512
W produkcji 20 zbadano fotomaski IX420N-32SR, IX420N-19SR i EPG 512 w celu określenia zależności grubości fotomaski od prędkości obrotowej wirówki, ich właściwości adhezyjnych, światłoczułości, rozdzielczości, odporności termicznej i plazmowej oraz odporności na odczynniki chemiczne.
1) Zależność grubości fotomaski od prędkości obrotowej V2 przedstawiono w tabelach 2,3,4. Na podstawie tych tabel możemy zauważyć, że przy tej samej prędkości obrotowej wirówki, weźmy dla przykładu 4500 obr/min, grubości różnią się ze względu na lepkość. Przy aplikacji IX420N-32CP grubość warstwy światłoczułej wynosi 1,57 mikrona, natomiast przy aplikacji EPG 512 grubość warstwy wynosiła 1,17, a przy IX420N-19CP - 1,10.
2) Światłoczułość podczas stosowania EM-584A:
a) Dla IX420N-32CP Czas ekspozycji jest 30-90% dłuższy niż SPR-700 w zależności od warstwy i 20-100% dłuższy niż S1813 (patrz tabela 5)
b) Dla IX42011-19CP czas ekspozycji jest o 30-50% dłuższy niż SPR-700 i 30-100% dłuższy niż S1813 (tabela 5)
c) Dla ERG 512 czas ekspozycji jest porównywalny do SPR -700 cm i 20-100% dłuższy niż S1813 (patrz tabela 5)
Światłoczułość w przypadku stosowania na fotomasce MRA, EM-576
IX420N-19SR przedstawiono w tabeli 5. Inne fotomaski nie były testowane w tych instalacjach ze względu na niską światłoczułość.
Tabela 2
Zależność grubości IX420H-32CP od prędkości obrotowej V2
|
Grubość powłoki, mikrony (lepkość 30cST) |
||
Tabela 3
Zależność grubości IX420H-19CP od prędkości obrotowej V2
|
Grubość powłoki, mikrony (lepkość 18,2 cST) |
||
Tabela 4 - Zależność grubości EPG 512 od prędkości obrotowej V2
3) Opór cieplny badano w 20 trybach pracy w produkcji - 112°C, 127, 160 z UV i bez UV.
Profil fotorezystu w różnych trybach utwardzania przedstawiono na rysunkach 2.1...2.10. Ze zdjęcia widać, że ramki IX420N-32SR i IX420N-19SR mają bardzo dużą odporność termiczną i prawie nie topią się nawet w 160°C, co nie pozwoli na ich wykorzystanie do planaryzacji. Jeśli konieczne jest ich użycie do planaryzacji, konieczna jest zmiana trybów hartowania.
Fotomaska EG 512 posiada wystarczającą odporność cieplną - na poziomie zastosowanych SPR-700 i S1813.
4) Odporność na środki trawiące.
a) IX420N-32SR, IX420P-19SR - do chemicznego trawienia metali
wyniki uzyskano gorsze niż w przypadku S1813. Były nierówne krawędzie i łzy. Płyty garbowane nie różniły się od niegarbowanych, choć płytki nałożone S1813 posiadały *
po wysuszeniu IR charakterystyczny czerwonawy kolor. Wielokrotne garbowanie przed trawieniem chemicznym poprawiło wynik, co na to wskazuje. które są skuteczne w przypadku środków chemicznych. tryby garbowania trawiącego dla tych typów f/r są niewystarczające. W przypadku konieczności ich stosowania konieczna jest zmiana trybów opalania w kierunku wzmacniającym.
b) EPG 512 - brak uwag dotyczących trawienia metali i warstw struktury aktywnej.
5) Odporność na plazmę IX420N-32SR, IX420N-19SR, EPG 512 na poziomie SPR700. Fotolitografii na metalu nie wykonywano przed ICT Al ze względu na silne oświetlenie boczne.
Tabela 5 - Porównawcze wartości narażenia dla istniejącego i eksperymentalnego f/r
|
tSPR/tIX420N-32SR |
tS1813/t IX420N-32SR |
tSPR/tIX420N-19SR |
tS1813/t IX420N-19SR |
|||
|
Metal 90/75, 155/165 SPR-700-1,8M (z barwnikiem) |
Metal 130/210 |
Metal 100/130 SPR-700-1,8M (z barwnikiem) |
Kolektor głęboki 65/140 |
Migawka 50/45, 125/130, 80/75 |
N+ drenuje 55/90 |
|
|
Kontakty 160/180 |
Pasywacja 140/170 |
Migawka 70/110 |
Pasywacja 80/115 |
Kontakty 115/110 |
Metal 110/160, 50/90 |
|
|
Kontakty 150/325 |
Metal 400/200* SPR-700-1,8M (z barwnikiem) |
Kontakty 90/190 |
||||
|
* - tex jest znacznie zmniejszony, aby wyeliminować boczne oświetlenie, aż do uzyskania minimalnego akceptowalnego rozmiaru |
1) Fotomaska IX420N-32SR umożliwia uzyskanie folii o grubości 1,4...2,5 µm;
IX420H-19CP - pozwala na produkcję folii o grubości 1,0...1,9 mikrona;
ERG 512 - umożliwia produkcję folii o grubości 1,1...2,0 mikrona;
2) Fotomaski IX420H-32SR, IX420N-19SR mają dobrą odporność na plazmę i są bardziej odpowiednie do zastąpienia SPR-700 w przypadku warstw przed trawieniem PC.
3) IX420N-32SR, IX420N-19SR charakteryzują się bardzo dużą wytrzymałością cieplną, co
a) nie pozwoli na ich wykorzystanie do planaryzacji;
b) spowoduje konieczność zmiany trybów opalania w kierunku zwiększania czasu i temperatury;
EG 512 ma taką samą odporność temperaturową jak SPR-700 i S1813.
4) IX420N-32SR, IX420N-19SR charakteryzują się bardzo niską światłoczułością, co powoduje niemal 2-krotne zmniejszenie produktywności instalacji projekcyjnych i kontaktowych.
Światłoczułość EPG 512 jest również niższa i kształtuje się na poziomie SPR -700, ale o 20...100% więcej niż S1813. co również znacznie zmniejsza produktywność instalacji
5) Nie ma alternatywy dla SPR-700-1,8M. Jeśli go nie ma, trzeba będzie wrócić na trasę z powłoką ?-Si, aby wyeliminować boczne oświetlenie na metalowej f/l.
6) Ze względu na niższą światłoczułość, w MPA-500 nie można stosować żadnego fotorezystu (obecnie MPA-500 wykorzystuje fotorezyst 9120).
7) Kompletny zamiennik używanego SPR-700-1.8M. SPR-700-1,2. S1813., 9120 od testowanych IX420N-32CP, IX420N-19CP, ERG 512 nr.
Najbardziej odpowiedni do druku projekcyjnego i stykowego (z wyjątkiem MPA-500) jest EPC 512, ale z nieuniknionym spadkiem wydajności i koniecznością dopracowania niektórych trybów i trasy.
Wniosek
Zgodnie z zadaniem rozważano dwa rodzaje fotomasek – pozytywowy i negatywowy. Na podstawie tabeli 1, w której zbadałem charakterystykę dwóch typów fotomasek, fotomaskę pozytywową uznano za optymalną. Określano ją według takich kryteriów, jak wpływ ekspozycji, wrażliwość na tlen, usuwanie warstwy rezystancyjnej, odporność chemiczna, wywoływanie, grubość FR, pokrycie FR stopni reliefowych.
W części teoretycznej zbadaliśmy trzy marki fotomasek pozytywowych, takie jak: IX420H-32CP, IX420H-19CP i EPG 512, które mają zastąpić SPR-700-1.8M. SPR-700-1,2., S1813, 9120.
Rezystory IX420H-32CP i IX420H-19CP nadawałyby się do zastąpienia SPR-700 dla warstw przed trawieniem PC, ze względu na ich odporność na plazmę, ale bardzo duża odporność cieplna nie pozwala na ich wykorzystanie do planaryzacji, a także wymaga zwiększenia zarówno czasu, jak i temperatury garbowanie. Odporność cieplna EPG 512 jest podobna do SPR-700 i S1813, co pozwala na zachowanie takich samych trybów opalania.
Światłoczułość IX420N-32SR i IX420N-19SR jest tak niska, że zmniejsza produktywność prawie 2 razy. EPG 512 ma również niską czułość na światło i zmniejsza wydajność.
Wśród testowanych nie ma kompletnego zamiennika dla stosowanych. Najbardziej odpowiedni do druku projekcyjnego i stykowego (z wyjątkiem MPA-500) jest EPC 512, ale z nieuniknionym spadkiem wydajności i koniecznością dopracowania niektórych trybów i trasy.
Opublikowano na Allbest.ur
...Podobne dokumenty
Właściwości chemiczne i fizyczne niklu oraz metody jego wykorzystania w przemyśle i technologii. Właściwości tetrakarbonylu niklu, metody laboratoryjnej syntezy tej substancji. Procesy technologiczne oparte na zastosowaniu karbonylku niklu.
praca na kursie, dodano 27.11.2010
Istota, rodzaje, metody wytwarzania, obszary zastosowań powłok metalowych. Technologia i cechy chemicznego srebrzenia szkła. Charakterystyka głównych metod chemicznego osadzania metali. Siła przyczepności warstwy metalu do powierzchni.
streszczenie, dodano 28.09.2009
Klasyfikacja aminokwasów i rodzaje ich izomerii. Właściwości chemiczne aminokwasów w zależności od obecności grupy karboksylowej, aminowej oraz łącznej obecności grup karboksylowych i aminowych. Procesy redoks z udziałem kwasów.
streszczenie, dodano 22.06.2010
Podstawowe właściwości fizyczne i chemiczne miedzi, informacje ogólne o metodzie produkcji, głównych obszarach zastosowań. Podstawowe właściwości fizyczne i chemiczne żelaza i stali niskowęglowej, ogólne informacje o sposobie produkcji, główne obszary zastosowań.
test, dodano 26.01.2007
Pojęcie i nazewnictwo fenoli, ich podstawowe właściwości fizyczne i chemiczne, reakcje charakterystyczne. Metody otrzymywania fenoli i ich zakres praktyczne zastosowanie. Toksyczne właściwości fenolu i jego natura negatywny wpływ na ludzkim ciele.
praca na kursie, dodano 16.03.2011
Nowoczesna metoda produkcji, główne zalety i wady aluminium. Mikrostruktura, właściwości fizyczne i chemiczne metali. Zastosowanie aluminium jako materiału szczególnie trwałego i lekkiego w przemyśle, rakietach, szklarstwie i pirotechnice.
prezentacja, dodano 20.10.2014
Budowa polisacharydów, charakterystyka ich głównych jednostek strukturalnych, właściwości chemiczne i fizyczne. Wymagania dla polimerów stosowanych w przemyśle naftowym, cechy ich zastosowania. Główni przedstawiciele biopolimerów, ich główne różnice.
test, dodano 14.11.2010
Historia odkrycia strontu. Będąc w naturze. Otrzymywanie strontu metodą aluminotermiczną i jego przechowywanie. Właściwości fizyczne. Właściwości mechaniczne. Charakterystyka atomowa. Właściwości chemiczne. Właściwości technologiczne. Obszary zastosowań.
streszczenie, dodano 30.09.2008
Cechy zastosowania metod izolacji, destylacji i strącania do oznaczania zawartości składników mineralnych, wody, cukrów, tłuszczów, witamin i innych składników w produktach spożywczych. Wymagania dla osadów w analizie grawimetrycznej.
prezentacja, dodano 27.02.2012
Zmiany właściwości fizykochemicznych powierzchni podczas nakładania powłok. Metody powlekania: chemiczne i elektrochemiczne, próżniowe osadzanie kondensacyjne, napawanie skoncentrowanymi źródłami ciepła, napawanie i natryskiwanie plazmowe.
Podobnie jak wielu innych, swoje pierwsze płytki drukowane rysowałem zapałką i lakierem nitro. Ścieżki okazały się niezbyt piękne, ale nie przeszkadzało to w prawidłowej pracy urządzeń.
Rysowałem też markerem.
Czas minął. Pracując latem w warsztacie, spotkałem gościa, który nauczył mnie LUT – technologii prasowania laserowego. Wydawało się, że co może być lepszego dla amatora?
Ale pewnego dnia w Internecie natknąłem się na wzmianki o fotomaskach, wszelkiego rodzaju POSITIV 20 itp. itp.
Dowiedziałem się, że za pomocą tego narzędzia można wykonać sygnet naprawdę wysokiej jakości... 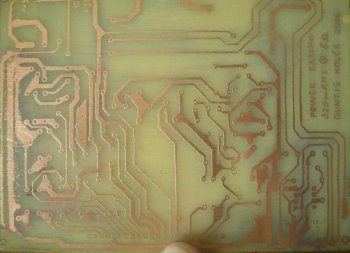
POZYTYW 20
A potem zobaczyłem w jednym ze sklepów z częściami do radia puszkę z napisem „POSITIV 20”. Przypomniałem sobie o sygnetach i kupiłem.Co to jest fotomaska? Jest to powłoka światłoczuła, która pozwala szybko i łatwo przenieść linie i kontury na różnorodne materiały. Istnieje możliwość wykonania nie tylko płytek drukowanych, ale także różnorodnych paneli czołowych, tabliczek znamionowych, różnorodnych matryc do trawienia metali, szkła i innych materiałów. Istnieją fotomaski dodatnie i ujemne. Dzieje się to również w formie filmu, ale sam czegoś takiego nigdy nie widziałem. W tym przypadku będziemy mówić tylko o fotomasce pozytywowej w puszkach, ponieważ jest ona najczęstsza.
Dane techniczne:
Kolor: ciemny fiolet;
Gęstość - 0,85 g/cm
Czas schnięcia - 24 godziny w temperaturze pokojowej, 15 minut. w temperaturze 70-80C.
Światłoczułość - w zakresie 310-440 nm (maks. w zakresie 330-410 nm) Oznacza to, że jest wrażliwy na światło ultrafioletowe.
Szablon zdjęcia szablonu
Wszystko zaczyna się od stworzenia rysunku płytki drukowanej w dowolnym dogodnym dla Ciebie edytorze - Układ sprintu, EagleCAD, PCAD lub jakikolwiek inny. Osobiście używam Sprint Layout, który leży w kolekcji oprogramowania datagor.
Następnie drukujemy rysunek na drukarce laserowej, ustawiając wcześniej maksymalną rozdzielczość drukarki, gęstość tonera na maksimum i kontrast na maksimum. Drukujemy na błyszczącej folii rzutowej. Jeśli nie masz drukarki laserowej, drukuj za pomocą drukarki laserowej przy max. Możliwa jakość. Można drukować także na papierze zwykłym, jednak wówczas należy go zaimpregnować aerozolem TRANSPARENT 21, który sprawi, że papier będzie przezroczysty dla promieni UV.
Nadal polecam używać drukarka laserowa ponieważ tylko dzięki niemu można uzyskać maksymalne krycie ścieżek szablonu. Mimo to, aby zwiększyć gęstość optyczną wzoru, niektórzy zalecają potraktowanie szablonu aerozolem Densitone Spray lub trzymanie szablonu przez pewien czas w parach acetonu. Ale i tak radzę sobie dobrze...
Powłoka fotorezystowa
W pierwszej kolejności należy dokładnie oczyścić tablicę tekstolitową i wysuszyć ją. Po czyszczeniu ważne jest, aby czysta płyta była całkowicie sucha, ponieważ resztkowa wilgoć tworzy silny efekt klejenia lakieru fotomaskowego.Musisz także upewnić się, że na desce nie ma kurzu.
Fotomaskę należy nakładać przy słabym świetle dziennym – nie jest wymagane zaciemnione pomieszczenie, lecz światło słoneczne lub jasne światło dzienne
należy unikać, ponieważ fotomaska jest wrażliwa na promienie UV.
Więc! Połóż deskę na lekko nachylonej, poziomej powierzchni i trzymając puszkę w odległości około 20 cm, nałóż warstwę serpentynowymi ruchami. Po krótkim czasie warstwa staje się cieńsza i tworzy się jednolita warstwa światłoczuła. Jeżeli nałożono nadmiar fotorezystu, a grubość powłoki jest nierówna lub niepożądana, należy wydłużyć czas naświetlania. Na krawędziach deski pozostanie jeszcze większa warstwa powłoki, dlatego trzeba wziąć nieco większą deskę i po wytrawieniu ją odciąć.
Suszenie deski
Następnie suszymy deskę w temperaturze 70-80C przez 15 minut. Ale możesz go wysuszyć w temperaturze pokojowej, chociaż będziesz musiał poczekać 24 godziny.Jedno ALE! Nie można od razu wystawiać płytki na działanie tej temperatury! Należy trzymać go w ciemnym miejscu przez około 30 minut, aby rozpuszczalnik i gaz odparowały z powłoki. W wyniku szybkiego nagrzewania może powstać gęsta warstwa powierzchniowa i ostatecznie nic się nie stanie. Niedostateczne wysuszenie powoduje powstawanie mikrodziur na powierzchni fotomaski i utratę przyczepności.
Do suszenia wykorzystuję stary piekarnik elektryczny, w którym zamontowałem termoparę z multimetru z funkcją termometru. Do określenia temperatury wewnątrz używam multimetru. Fajną opcją jest oczywiście suszarka do włosów z termostatem, ale piekarnik nie jest gorszy.
Wystawa
Deska jest suszona – przystępujemy do wystawy. Moja konfiguracja wygląda następująco.
Lampa UV to lampa „czarnego światła” (taka, jakiej używa się w dyskotekach). Zasilana balastem żarówek energooszczędnych.
NIGDY NIE UŻYWAJ TWARDYCH LAMP UV!(na przykład kolba wewnętrzna z DRL-400 i tym podobne).
Zadbaj o swój wzrok – to jedna z najcenniejszych rzeczy, jaką dała nam natura! Opłata nie jest tego warta!
Kontynuuję - od początku kładziemy powlekaną deskę na gładkiej powierzchni, nakładamy szablon na deskę i przykrywamy całość szkłem kwarcowym lub nierysowaną plexi (zwykłe szkło blokuje do 65% promieni UV - żeby nie przeszło z dala!). Małe tablice można również zabezpieczyć w pudełkach na płyty CD. Odległość lampy od tablicy wynosi 15...30 cm.
Czas ekspozycji zależy od grubości powłoki i wielkości płyty. Będziesz musiał tutaj poeksperymentować. Wszystkie deski wystawiam na działanie promieni UV przez 6 minut – to wystarczy.
Rozwój
Wyschnięta i odsłonięta warstwa fotorezystu pojawia się w normalnym świetle dziennym (w pomieszczeniu nieoświetlonym bezpośrednio światłem słonecznym). Przygotuj roztwór wywoływacza: 7 gramów wodorotlenku sodu (NaOH) w 1 litrze wody. Wywoływanie należy prowadzić w temperaturze +20-25°C. Niższa temperatura spowolni proces rozwoju, podwyższona temperatura go przyspieszy, ale jednocześnie zmniejszyostrość obrazu. Po wywołaniu wypłucz deskę pod bieżącą wodą. W przypadku prawidłowo naświetlonego fotomaski czas wywoływania wynosi od 30 do 60 sekund w świeżym roztworze wywoływacza.
Sam używam produktu KRET do czyszczenia rur kanalizacyjnych. Prawie czysty NaOH. Ilość dobieram na oko.
Podczas procesu wywoływania nadmiar fotorezystu jest zmywany. Po wywołaniu widoczne są tylko ścieżki.
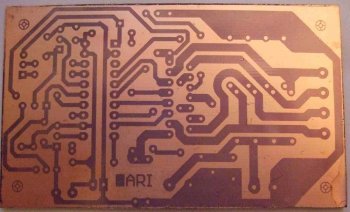
Wszystko! Wrzuć płytkę do ulubionego roztworu do trawienia i czekaj! W rezultacie otrzymujemy całkiem niezłą zapłatę.
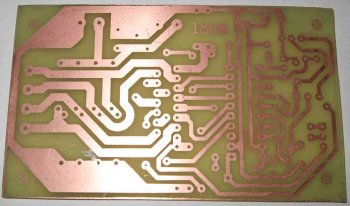
Efekt ekonomiczny
POSITIV 20 kosztuje ok. 15$ . Jedna puszka 200 ml wystarcza na 3,5 m2 (biorąc pod uwagę, że grubość powłoki nie zawsze jest taka sama). W całkowitym koszcie płytki drukowanej udział kosztu fotomaski jest znikomo mały.Kilka tablic, które zrobiłem
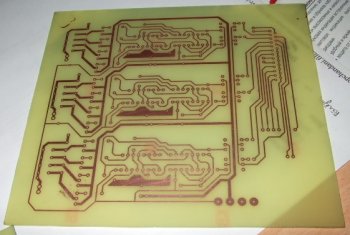
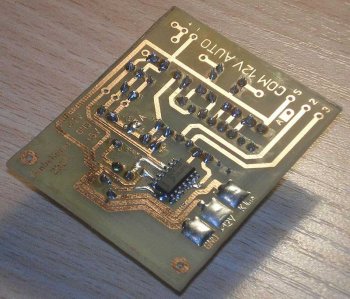
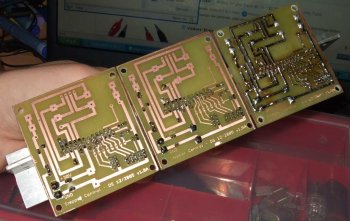
Powodzenia wszystkim!
Guntisa Kolcha
Wynalazek dotyczy pozytywowych fotomasek i może być stosowany w procesach fotolitograficznych przy wytwarzaniu układów scalonych w mikroelektronice i elektronice radiowej. Proponuje się fotomaskę pozytywową zawierającą w % wag.: żywicę nowolakowo-krezolowo-formaldehydową 60 - 66,5; diester 1,2 - naftochinodiazydo-(2), kwas 5 - sulfonowy i dwutlenek 2,4 - benzofenonu 30 - 33; związek organiczny o właściwościach oddających elektrony, wybrany z zakresu: p-dimetyloaminobenzaldehyd, p-dietyloaminobenzaldehyd, p-fenylenodiamina, nitrozodietyloanilina, o-fenylenodiamina, ferrocen 2 - 9 i pozostała część rozpuszczalnika organicznego. Fotomaska ma wysoką czułość do badania w bliskim ultrafiolecie, wysoki kontrast i odporność w środowisku kwaśnym.
Wynalazek dotyczy pozytywowych fotomasek, które stosuje się w procesach fotolitograficznych przy wytwarzaniu układów scalonych w mikroelektronice, radioelektronice i innych gałęziach przemysłu.
Znane są fotomaski dodatnie, które zawierają diester kwasu 1,2-naftochinodiazydo-(2), kwasu 5-sulfonowego i 2,4,4"-di-, tri-, tetrahydroksybenzofenonu jako fotoaktywator lub mieszaninę sulfoestrów jako spoiwo polimerowe , żywica fenolowo-formaldehydowa i rozpuszczalnik organiczny.
Wadą znanych fotomasek jest ich niska światłoczułość (250 mJ/cm2).
Najbliższy proponowanemu pod względem składu i właściwości jest fotomaska pozytywowa zawierająca mieszaninę sulfoeterów jako fotoaktywator: diester 1,2-naftochinodiazydu (2), kwasu 5-sulfonowego i 2,4-dioksybenzofenonu (1); diester kwasu 1,2-naftochinodiazydo-(2),5-sulfonowego i 2,2,4,4-tetraosibenzofenonu (II); diester kwasu 1,2-naftochinodiazydo-(2), kwasu 5-sulfonowego i metylenobis(2,4-dioloksybenzofenonu) (III); kopolimer blokowy krzemoorganiczny; składnik błonotwórczy – żywica krezolowo-formaldehydowa gatunku SF-142B (TU 6-05-231-277-88) i skład  gdzie n= 6-12; średnia masa 7000-17000 i rozpuszczalnik organiczny będący mieszaniną octanu monometyloeteru i glikolu etylenowego, eteru dimetylowego, glikolu dietylenowego i ksylenu w następującym stosunku składników, wag.
gdzie n= 6-12; średnia masa 7000-17000 i rozpuszczalnik organiczny będący mieszaniną octanu monometyloeteru i glikolu etylenowego, eteru dimetylowego, glikolu dietylenowego i ksylenu w następującym stosunku składników, wag.
Diester 1,2-naftochinodiazydo-(2), kwasu 5-sulfonowego i 2,4-dioksybenzofenonu 1,3 1,57 Diester 1,2-naftochinodiazydo-(2), kwasu 5-sulfonowego i 2,2,4,4-tetraoksybenzofenonu 3,14 5,2 Diester kwasu 1,2-naftochinodiazydo-(2), 5-sulfonowego i metylenobis(2,4-dioksybenzofenonu) 3,8 5,4 Kopolimer blokowy krzemoorganiczny 0,015 0,03 Żywica nowolakowa krezolowo-formaldehydowa 18,1 21,75 Eter dimetylowy glikolu dietylenowego 5,52 7,19 Ksylen 3,45 4,97
Eter monometylowy glikolu acetylenowego Reszta
Fotomaska charakteryzuje się światłoczułością na poziomie 80 mJ/cm2, a rozdzielczość materiału, czyli minimalna szerokość powtarzalnego elementu, wynosi 0,8 – 1,0 mikrona. W prototypie nie określono współczynnika kontrastu.
Wadą prototypu jest jego niska światłoczułość, co ogranicza obszary zastosowań fotomaski.
Wynalazek rozwiązuje problem zwiększania światłoczułości bez pogarszania rozdzielczości fotomaski pozytywowej.
Problem rozwiązano w ten sposób, że pozytywowa fotorezyst zawierająca diester 1,2-naftochinodiazydo-(2), kwasu 5-sulfonowego i 2,4-di-hydroksybenzofenonu oraz żywicę krezolowo-formaldehydową o wzorze (1) zawiera dodatkowo związek organiczny, który oznacza donor elektronów, wybrany spośród takich jak: p-dimetyloaminobenzaldehyd lub p-dietyloaminobenzaldehyd, lub nitrozodietyloanilina, lub p-fenylenodiamina, lub o-fenylenodiamina, lub ferrocen. Stosowanym rozpuszczalnikiem był eter dimetylowy glikolu dietylenowego lub eter monometylowy octanu glikolu etylenowego.
Wybór żywicy krezolowo-formaldehydowej jako matrycy błonotwórczej wynika z jej rozpuszczalności w roztworach wodno-alkalicznych oraz odporności chemicznej, tj. odporność, w środowiskach kwaśnych, zwykle używana do trawienia słów z tlenku metalu. Ponadto żywica krezolowo-formaldehydowa, ze względu na swój aromatyczny charakter, posiada wystarczającą odporność na warunki trawienia na sucho, takie jak bombardowanie jonami.
Proporcje tych składników są następujące: wag.
Żywica nowolakowa krezolowo-formaldehydowa 60 66,5
Diester kwasu 1,2-naftochinodiazydo-(2),5-sulfonowego i 2,4-dioksybenzofenonu
30 33
Związek organiczny 2 9
Rozpuszczalnik organiczny Reszta
Zastosowanie dodatku określonego związku organicznego w określonych ilościach powoduje wzrost współczynnika kontrastu fotomaski pozytywowej o 1,1-1,5 razy i światłoczułości o 1,4-2 razy w porównaniu z kompozycją bez dodatków (przykłady 1-10) , a w porównaniu do prototypu światłoczułość wzrasta 1,7 4,5 razy.
Związek organiczny stosowany jako dodatek do kompozycji na fotomaskę pozytywową musi koniecznie posiadać właściwości oddające elektrony. Wprowadzenie do kompozycji związku niebędącego donorem (na przykład błękitu metylenowego aminy, który ma właściwości akceptorowe) nie prowadzi do wzrostu światłoczułości ani współczynnika kontrastu (przykład 11).
Autorzy wiedzą, że aminy i diaminy stosuje się w kompozycjach na bazie żywicy nowolakowej i diazydków o-naftochinonu w celu przekształcenia fotomaski pozytywowej w fotomaskę ujemną o niskiej czułości.Jeśli chodzi o efekt zwiększenia światłoczułości pozytywowej fotomaski na bazie żywicy nowolakowej i diazydków o-naftochinonu przy wprowadzaniu do warstwy tych samych dodatków, ale w stężeniach określonych w proponowanym zgłoszeniu, nie jest to znane w literaturze.
Autorzy wiedzą również, że p-dimetyloaminobenzaldehyd stosuje się w celu zwiększenia światłoczułości negatywowych fotomasek.W warstwach tych po pierwotnym naświetleniu zachodzą reakcje termiczne procesu wzmocnienia chemicznego, związane z protonowaniem p-dimetyloaminobenzaldehydu i utworzeniem formy enolowej protonowanego p-dimetyloaminobenzaldehydu o niskim potencjale utleniania (0,49 B w stosunku do elektrody z chlorku srebra). W tych samych kompozycjach, przy zastąpieniu p-dimetyloaminobenzaldehydu p-dietyloaminobenzaldehydem, nie występuje efekt wzmocnienia chemicznego. Wynika to z faktu, że p-dietyloaminobenzaldehyd nie tworzy formy enolowej o niskim potencjale utleniania.Protonowane formy innych związków stosowanych w proponowanym fotomasce nie tworzą tautomeru enolowego. Z tego co zostało powiedziane wynika, że wzrost światłoczułości w naszym przypadku nie jest związany z procesami chemicznego wzmacniania, ale przebiega poprzez inny mechanizm.
Przykład 1. Fotomaskę wytwarza się przez rozpuszczenie diestru 1,2-naftochinodiazydu (2), kwasu 5-sulfonowego i 2,4-dioksybenzofenonu, żywicy nowolakowo-krezolowo-formaldehydowej gatunku SF-141, wag., w eterze dimetylowym glikolu dietylenowego.
Żywica 66,5
Fotoaktywator 33
Przygotowaną kompozycję nanosi się na podłoże technologiczne i po całkowitym usunięciu rozpuszczalnika warstwę fotomaski naświetla się światłem UV i wywołuje przez 60 s w 0,6% roztworze KOH. Czułość na światło zdefiniowano jako ekspozycję wymaganą do całkowitego usunięcia naświetlonych obszarów z podłoża i wynosiła 46,5 mJ/cm2, współczynnik kontrastu 1,1.
Przykład 2. Fotomaskę wytwarza się, nakłada i przetwarza jak wskazano w przykładzie 1 przy stosunku składników wagowych.
Żywica 65
Fotoaktywator 32.7
p-dimetyloaminobenzaldehyd 2
Rozpuszczalnik Eter dimetylowy glikolu dietylenowego Reszta
Światłoczułość fotomaski wynosi 40 mJ/cm2, współczynnik kontrastu wynosi 1,15.
Przykład 3. Fotomaskę wytwarza się, nakłada i przetwarza jak wskazano w przykładzie 1 przy stosunku składników wagowych.
Żywica 63
Fotoaktywator 31.6
p-dimetyloaminobenzaldehyd 4.7
Rozpuszczalnik Eter dimetylowy glikolu dietylenowego Reszta
Światłoczułość fotomaski wynosiła 26,5 mJ/cm2, a współczynnik kontrastu 1,8.
Przykład 4. Fotomaskę wytwarza się, nakłada i przetwarza jak wskazano w przykładzie 1 przy stosunku składników wagowych.
Żywica 60,7
Fotoaktywator 30.5
p-dimetyloaminobenzaldehyd 8.1
Rozpuszczalnik Eter dimetylowy glikolu dietylenowego Reszta
Światłoczułość fotomaski wynosiła 23 mJ/cm2, a współczynnik kontrastu 2,0.
Przykład 5. Fotomaskę wytwarza się, nakłada i przetwarza jak wskazano w przykładzie 1 przy stosunku składników wagowych.
Żywica 60.3
Fotoaktywator 30
p-dimetyloaminobenzaldehyd 9
Rozpuszczalnik Eter dimetylowy glikolu dietylenowego Reszta
Światłoczułość fotomaski wynosiła 38 mJ/cm2, a współczynnik kontrastu 1,2.
Przykład 6. Fotomaskę wytwarza się, nakłada i przetwarza jak wskazano w przykładzie 1 przy stosunku składników wagowych.
Żywica 64,5
Fotoaktywator 33
Nitrozodimetyloanilina 2.3
Rozpuszczalnik Eter dimetylowy glikolu dietylenowego Reszta
Światłoczułość fotomaski wynosiła 30 mJ/cm2, a współczynnik kontrastu 1,4.
Przykład 7. Fotomaskę wytwarza się, nakłada i przetwarza jak wskazano w przykładzie 1 przy stosunku składników wagowych.
Żywica 62,5
Fotoaktywator 31
p-fenylenodiamina 5,8
Rozpuszczalnik Eter dimetylowy glikolu dietylenowego Reszta
Światłoczułość fotomaski wynosiła 18 mJ/cm2, a współczynnik kontrastu 1,7.
Przykład 8. Fotomaskę wytwarza się, nakłada i przetwarza jak wskazano w przykładzie 1 przy stosunku składników wagowych.
Żywica 64,5
Fotoaktywator 31.7
o-Fenylenodiamina 3
Rozpuszczalnik Eter dimetylowy glikolu dietylenowego Reszta
Światłoczułość fotomaski wynosiła 23 mJ/cm2, a współczynnik kontrastu 1,5.
Przykład 9. Fotomaskę wytwarza się, nakłada i przetwarza jak wskazano w przykładzie 1 przy stosunku składników wagowych.
Żywica 60,7
Fotoaktywator 30.5
p-dietyloaminobenzaldehyd 8.1
Rozpuszczalnik Eter dimetylowy glikolu dietylenowego Reszta
Światłoczułość fotomaski wynosiła 37 mJ/cm2, a współczynnik kontrastu 1,5.
Przykład 10. Fotomaskę wytwarza się, nakłada i przetwarza jak wskazano w przykładzie 1 przy stosunku składników wagowych.
Żywica 65
Fotoaktywator 32.6
Ferrocen 2.1
Rozpuszczalnik Eter dimetylowy glikolu dietylenowego Reszta
Światłoczułość fotomaski wynosiła 35 mJ/cm2, a współczynnik kontrastu 1,8.
Przykład 11. Fotomaskę wytwarza się, nakłada i przetwarza jak wskazano w przykładzie 1, stosunek składników wagowych.
Żywica 62,5
Fotoaktywator 31
Błękit metylenowy 5,8
Rozpuszczalnik Eter dimetylowy glikolu dietylenowego Reszta
Światłoczułość fotomaski wynosiła 46,5 mJ/cm2, a współczynnik kontrastu 1,1.
Zatem opracowana fotomaska łączy wysoką czułość na promieniowanie w bliskim ultrafiolecie z wysokim kontrastem i odpornością w środowiskach kwaśnych, w tym bombardowaniu jonami.
Dzięki temu najlepiej nadaje się do stosowania w procesach fotografii projekcyjnej z trawieniem plazmą jonową, stosowanych np. w technologii VLSI DOS o pojemności pamięci 1-16 MB, gdzie konieczne jest formowanie masek ochronnych o szerokości elementów 1,0-0,6 μm z niemal pionowym nachyleniem ścian i zwiększoną produktywnością w modułowych operacjach naświetlania.
Fotomaska pozytywowa zawierająca diester kwasu 1,2-naftochinodiazydo-(2),5-sulfonowego i 2,4-dioksybenzofenonu, żywicę nowolakowo-krezolowo-formaldehydową oraz rozpuszczalnik organiczny, znamienna tym, że fotomaska zawiera dodatkowo związek organiczny z elektronem - właściwości donorowe, wybrane z zakresu: p-dimetyloaminobenzaldehyd lub p-dietyloaminobenzaldehyd, lub nitrozodietyloanilina, lub p-fenylenodiamina, lub o-fenylenodiamina lub ferrocen, w następującym stosunku składników, wag.
Wynalazek dotyczy kompozycji wrażliwych na promieniowanie, które zmieniają współczynnik załamania światła, pozwalających uzyskać nowy model rozkładu współczynnika załamania światła, w szczególności materiału optycznego stosowanego w dziedzinie optoelektroniki i urządzeń wyświetlających informacje
Wynalazek dotyczy dziedziny rejestracji obrazu. Metoda polega na utworzeniu światłoczułej warstwy folii z jednościennych nanorurek węglowych zawierających kapsułkowane nanocząstki żelaza na szklanym podłożu. Na folię nakłada się warstwę roztworu kwasu i naświetla się ją skupionym promieniowaniem laserowym według zadanego programu, w celu uzyskania pożądanego obrazu. Obraz rejestrowany jest na kliszy poprzez reakcje chemiczne zachodzące podczas nagrzewania lasera pomiędzy nanocząsteczkami żelaza zamkniętymi w nanorurkach a roztworem kwasu nałożonym na kliszę przed procedurą rejestracji. Rezultatem technicznym jest uproszczenie sposobu rejestracji obrazu i zmniejszenie zużycia energii. 5 pensja f-ly, 2 chory.
Najpowszechniejszą dziś, a zarazem najlepszą, jest metoda pozytywowa wytwarzania form drukowanych ( Płytki drukowane), w oparciu o zastosowanie związków diazowych, diazydów ortonaftochinonu (ONQD). W rzeczywistości wszystkie rodzaje fotomasek pozytywowych to nic innego jak ONCD i różnią się od siebie jedynie składem rozpuszczalników, ilością składnika światłoczułego i kompozycją błonotwórczą.
W wyniku działania strumienia promieniowania aktynicznego na diazydy orto-naftochinonu w warstwie kopii przez szkiełko pojawia się ukryty obraz. W obszarach oświetlonych warstwa kopiowa zmienia swoje pierwotne parametry fizykochemiczne, przede wszystkim rozpuszczalność w słabych roztworach środków alkalicznych.
Przekształcenie obrazu ukrytego w obraz jawny (uzyskanie kopii na materiale płyty) następuje w wyniku usunięcia warstwy z oświetlanych obszarów, czyli wywołania kopii.Wywoływanie, jak już wskazano, odbywa się za pomocą wodno-alkalicznego roztwory: produkty fotochemicznego rozkładu ONCD - kwasy indenokarboksylowe - reagują z zasadami, tworząc rozpuszczalną w wodzie sól, która po rozwinięciu przechodzi do roztworu.
Należy zauważyć, że podczas ekspozycji tylko część ONCD ulega zniszczeniu, a około 30% pozostaje niezmienione. Po wywołaniu w roztworze zasadowym zachodzi reakcja sprzęgania azowego pomiędzy oryginalnym ONCD i kwasem indenokarboksylowym, w wyniku której powstaje barwnik azowy, który prowadzi do zabarwienia oświetlonych obszarów kopii. Ogólnie proces wywoływania można sobie wyobrazić jako składający się z 4 etapów: zwilżanie powierzchni roztworem wywołującym; dyfuzja roztworu przez pory i pęknięcia warstwy, pęcznienie warstwy; osłabienie wiązania kleju i odklejenie folii od podłoża; mechaniczne usuwanie folii.
Ze względu na małą grubość warstwy kopiowej wszystkie te etapy przebiegają bardzo szybko. Zwilżanie jest pierwszą czynnością działania wywoływacza na naświetlaną warstwę. Dobre zwilżanie wynika z obecności w folii kwasów karboksylowych i nowolakowych żywic fenolowo-formaldehydowych. W miarę wnikania wywoływacza w podłoże błona pęcznieje, podczas czego tworzą się rozpuszczalne w wodzie sole kwasów karboksylowych, rozpuszcza się żywica nowolakowa, pomiędzy zniszczonymi i pierwotnymi składnikami diazowymi tworzą się rozpuszczalne w wodzie barwniki azowe, a folia zostaje zdyspergowana. fakt, że folia zawiera także składniki nierozpuszczalne w zasadach (żywice epoksydowe), nie powoduje całkowitego chemicznego rozpuszczenia folii. Na skutek odklejenia się folii od podłoża i rozpuszczenia poszczególnych składników, rozproszone cząstki usuwane są w sposób mechaniczny.
Zazwyczaj jako roztwory wywołujące stosuje się 2-5% roztwory fosforanu trójsodowego lub 1-2% roztwory krzemianu sodu. Można stosować 0,2-0,5% roztwory sody kaustycznej. Skład, stężenie i temperatura rozwijających się roztworów odgrywają niezwykle ważną rolę w procesie wywoływania. Choć głównym celem wywoływania jest usunięcie oświetlonych obszarów warstwy kopiowej, równie ważne jest, aby obszary nieoświetlone nie zmieniły swoich właściwości fizykochemicznych. A ponieważ folie zawierają rozpuszczalne w alkaliach żywice fenolowo-formaldehydowe, podczas wywoływania warstwa ulega częściowemu zniszczeniu w nieoświetlonych obszarach.Stopień tego zniszczenia zależy od powyższych parametrów roztworów wywołujących, a także od czasu (szybkości) manifestacji odporności na alkalia warstwy kopiującej.
Aby scharakteryzować układ warstwa kopiująca-wywoływacz, wygodnie jest zastosować dwa wskaźniki: czas wywoływania T obszarów oświetlonych i „selektywność wywoływania” W, określoną przez stosunek czasu rozpoczęcia niszczenia obszarów nieoświetlonych warstwy T n.r do czasu wywoływania:
W=T nr/T pr.
Parametr „selektywność manifestacji” odzwierciedla stopień krytyczności manifestacji, a tym samym stopień wiarygodności proces technologiczny. Im większe W, tym mniejsze odchylenia od warunków procesu kopiowania będą miały wpływ na jakość kopii, tym mniejsze ryzyko potencjalnych wad, tym bardziej niezawodny układ warstwa kopiująca-wywoływacz. Ponadto przy stałym składzie warstwy indeks W pozwala wybrać najlepszego dewelopera i optymalne tryby ekspozycja i rozwój. Tabela 1 pokazuje wartości W dla niektórych rozwijających się rozwiązań.
Wywoływacz na metakrzemianu sodu działa najbardziej selektywnie (W = 20), inne wywoływacze nie podają wymaganej wartości W. Jeśli weźmiemy pod uwagę, że rzeczywisty czas wywoływania ze względu na duży format płytek wynosi 1,5-2 minuty, to Wartość W zmniejsza się do 1-2,5, co wskazuje na zniszczenie nienaświetlonych obszarów warstwy i zmniejszenie jej właściwości ochronnych. Jednym ze skutecznych sposobów zwiększenia selektywności wywoływania jest obróbka cieplna kopii po naświetleniu, przed procesem wywoływania. Oczywiście temperaturę obróbki cieplnej należy dobrać w taki sposób, aby w narażonych obszarach nie doszło do zniszczenia kwasu indenokarboksylowego. Udowodniono eksperymentalnie, że obróbka cieplna po naświetlaniu wpływa na wartość W począwszy od 90°C. W tym przypadku efekt zależy zarówno od czasu suszenia, jak i temperatury. W tabeli Na rysunku 2 przedstawiono zmianę wartości W w zależności od temperatury obróbki cieplnej.
| Deweloper | Czas zniszczenia warstwy nienaświetlonej, s, w temperaturze obróbki cieplnej, C° |
|||||
|---|---|---|---|---|---|---|
| 80 | 90 | 100 | 110 | 120 | ||
| Na2SiO 3 | 480 | 1320 | 1500 | 2880 | 3060 | |
| Na3PO4 | 360 | 1020 | 1080 | 1800 | 1980 | |
| NaOH | 180 | 600 | 900 | 1860 | 2040 | |
Jak widać z tabeli. 2, obróbka cieplna w temperaturze 90-110°C prowadzi do gwałtownego wzrostu selektywności wywoływania dla wszystkich roztworów wywołujących ze względu na znaczny wzrost W nienaświetlonej warstwy.
Do praktycznego zastosowania można zalecić obróbkę cieplną naświetlonych kopii w temperaturze 100-110° C. Czas wywoływania i naświetlania są ze sobą powiązane i muszą być dobrane w taki sposób, aby zapewnić jak największą rozdzielczość procesu. Bardzo skuteczne są mieszaniny krzemianu sodu i wodorotlenku sodu. Ich stężenie i stosunek dobiera się tak, aby W wynosiło co najmniej 20.
Wady wytwarzania form drukarskich na bazie diazydków ortonaftochinonu i ich eliminacja.
Pomimo różnorodności możliwości technologicznych wytwarzania form drukowych z warstwą kopiową na bazie ONCD, we wszystkich przypadkach główną operacją technologiczną decydującą o jakości form drukowych jest wywoływanie; większość wad formy wiąże się z „niedorozwojem” lub „nadmiernym rozwinięciem” kopii .
Skład kompozycji
Problem tworzenia kompozycji światłoczułych na bazie ONCD polega na doborze składników światłoczułych i błonotwórczych, które zapewniają warstwie kopiowej dużą czułość całkową i widmową.
Znacząca rozdzielczość małych elementów rastrowych i liniowych, a także niezbędna ciągłość filmu, przyczepność do podłoża płytowego, wytrzymałość mechaniczna i odporność chemiczna.
ONCD, jako związki oligomeryczne, mają zdolność tworzenia błon z roztworów w rozpuszczalnikach organicznych. Folie te mają jednak nierówną grubość i nie spełniają powyższych wymagań. Dlatego ONCD pełnią jedynie funkcje składników światłoczułych w kompozycjach.
Składniki błonotwórcze kompozycji dobiera się zgodnie z następującymi wymaganiami: dobra rozpuszczalność w rozpuszczalnikach dla ONCD; kompatybilność z ONCD w szerokim zakresie stężeń; łatwe usuwanie wraz z produktami fotolizy ONCD podczas wywoływania kopii.
Ostatni warunek ogranicza liczbę środków błonotwórczych jedynie do polimerów rozpuszczalnych w słabych roztworach alkalicznych. Powyższe wymagania w największym stopniu spełniają żywice fenolowo-formaldehydowe. Mają budowę liniową, dzięki czemu są termoplastyczne, dobrze rozpuszczają się w wielu rozpuszczalnikach i posiadają wysokie właściwości błonotwórcze. Badania żywic nowolakowych SF-010 (iditol), SF-012 (Novolak - 18) z ONHD wykazały, że po wprowadzeniu ich do roztworu kopiującego zmieniają się właściwości błonotwórcze roztworu, jednorodność i jednorodność filmów oraz kwasowość odporność ulega poprawie. Jednakże ze względu na rozpuszczalność żywic nowolakowych w roztworach alkalicznych warstwa kopiowa staje się bardzo wrażliwa na działanie wywoływacza i wartość pH roztworu wywołującego.
Jednym ze sposobów zwiększenia odporności chemicznej jest wprowadzenie dodatków zwiększających przyczepność i hydrofobowość folii. Powszechnie wiadomo, że żywice rezolowe fenolowo-formaldehydowe zawierają wiele wolnych grup metylolowych, co decyduje o ich dużej reaktywności. Przyczepność do metalu i tendencja do tworzenia trójwymiarowych struktur siatkowych w temperaturach powyżej 150°C C. Wprowadzenie żywicy rezolowej SF-340A, lakieru bakelitowego i żywicy „101” znacznie zwiększa odporność chemiczną filmów światłoczułych, jednak ich zastosowanie jest ograniczone, ponieważ duże stężenia utrudniają wywoływanie kopii.
Folie wykonane z roztworów żywicy epoksydowej posiadają kompleks cennych właściwości. Wyróżniają się znaczną twardością, wyjątkową przyczepnością do metali, elastycznością, odpornością na warunki atmosferyczne, odpornością chemiczną, wysokimi właściwościami elektroizolacyjnymi i odpornością na znaczne wahania temperatury.
Największym zainteresowaniem cieszą się lakiery na bazie wysokocząsteczkowej żywicy epoksydowej E-05, lakier EP-527 i FL-5127, które posiadają wszystkie powyższe właściwości, ale nie wymagają wprowadzania utwardzacza do roztworu i rozpuszczania w etylowym cellosolwie . Praktyka potwierdziła możliwość wprowadzenia lakierów PL do kompozycji światłoczułej. Jednocześnie znacznie zwiększa się odporność chemiczna warstwy kopii i właściwości elektroizolacyjne, a wywoływalność kopii nie ulega pogorszeniu.
Interesujące są polimery o dużej masie cząsteczkowej, poliwinylobutyral i diflon. Poliwinylobutyral charakteryzuje się dobrymi właściwościami optycznymi (przezroczystość, bezbarwność, odporność na działanie światła) oraz wysoką przyczepnością do metali. W podwyższonych temperaturach poliwinylobutyral może oddziaływać ze składnikami rezolowymi warstwy kopiowej, znacznie zwiększając jej właściwości ochronne i hydrofobowość. Folie Diflon charakteryzują się wysoką przezroczystością optyczną, odpornością na promienie UV, niską higroskopijnością, podwyższoną odpornością na uderzenia i wytrzymałością na zginanie.
Wszystkie powyższe polimery i oligomery spełniają wymagania dotyczące składników błonotwórczych kompozycji. Jednakże ze względu na zwiększoną odporność na alkalia są to dodatki wymienne, wprowadzane do roztworu światłoczułego w ograniczonych ilościach w celu poprawy właściwości technologicznych warstwy kopiowej. Głównymi składnikami znanych rozwiązań krajowych i zagranicznych są światłoczułe ONCD i błonotwórcze żywice nowolakowe. Ogólnie stosunek stężeń składników światłoczułych i wszystkich składników błonotwórczych wynosi od 1:1,25 do 1:2,5.
Zatem roztwory światłoczułe na bazie ONCD są wieloskładnikowymi układami monomer-polimer, których składniki niosą wyraźny, funkcjonalny ładunek - z jednej strony są ze sobą powiązane i dopiero w połączeniu zapewniają niezbędne parametry warstw światłoczułych .
Tworzenie warstwy światłoczułej
Proces tworzenia filmu i warunki tworzenia filmu warstwy światłoczułej mają istotny wpływ na właściwości tej warstwy; przyczepność do podłoża, wytrzymałość mechaniczna, odporność chemiczna, manifestacja, stabilność wskaźników w czasie. Nakładanie warstwowe jest jedynie pierwszym etapem tworzenia powłoki i polega na zwilżeniu powierzchni metalu podłoża, rozprowadzeniu roztworu i częściowym odparowaniu rozpuszczalnika. Głównym celem tego etapu jest wytworzenie jednolitej folii o określonej grubości, która zależy od lepkości roztworu i szybkości rozprowadzania warstwy. Aby nałożyć warstwę przez odwirowanie i w polu elektrycznym, stosuje się roztwory o lepkości 11 s według „VZ-4”, dla metody walcowej - o lepkości 17-20 s. Wymaganą lepkość osiąga się stosując bardziej stężone roztwory.
Drugi etap tworzenia powłoki – suszenie – ma na celu odparowanie rozpuszczalnika i utworzenie suchej na powietrzu powłoki o niezbędnej przyczepności do podłoża, twardości i wytrzymałości mechanicznej. Kiedy rozpuszczalniki odparowują, objętość folii zmniejsza się, w wyniku czego powstają naprężenia wewnętrzne, a obecność podłoża we wszystkich przypadkach prowadzi do ich wzrostu.
Proces tworzenia powłoki wiąże się ze wzrostem twardości, w systemach farb i lakierów uważa się go za zakończony dopiero wtedy, gdy w folii wykształcą się wszystkie możliwe wiązania, czyli uzyskana zostanie najtrwalsza powłoka. W przypadku folii światłoczułych niedopuszczalne jest tworzenie się wiązań chemicznych pomiędzy składnikami, a także z podłożem. Ponadto nie powinno dojść do zniszczenia światłoczułej grupy ONCD. W związku z tym temperaturę suszenia dobiera się w taki sposób, aby nastąpiło całkowite, ale stopniowe usunięcie rozpuszczalnika i zaszły procesy relaksacji, zwiększające przyczepność powłoki i zmniejszające naprężenia wewnętrzne. Interakcja międzycząsteczkowa i adhezja muszą być zapewnione jedynie przez fizyczne siły van der Waalsa.
Rodzaj zastosowanych rozpuszczalników ma duży wpływ na tworzenie się filmu. Im wyższa temperatura wrzenia rozpuszczalnika, tym mniejsze napięcie utrzymuje się w folii. Rozpuszczalniki o wysokiej temperaturze wrzenia, usuwane powoli i być może nie całkowicie podczas suszenia folii, mają działanie uplastyczniające. Dlatego procesy relaksacji w obecności takich rozpuszczalników zachodzą intensywniej, co prowadzi do minimalnych wartości naprężeń.
Biorąc powyższe pod uwagę, dla warstwy na bazie ONCD zaleca się następujące tryby suszenia: w wirówkach - 50 - 60°C przez 10 minut; na instalacji FSL - 80°C przy prędkości przenośnika 1,6 m/min; na instalacji rolkowej - 120° C przy prędkości taśmy 40 m/min.
Dobór rozpuszczalników
Charakter rozpuszczalnika kompozycji światłoczułych ma istotny wpływ na ich stabilność podczas przechowywania, na proces tworzenia się żużla i właściwości utworzonej warstwy kopiowej.Przemysł produkuje szeroką gamę rozpuszczalników organicznych, które różnią się budową chemiczną i właściwościami: temperatura wrzenia, szybkość parowania, temperatura zapłonu, toksyczność itp.
Kryteriami wyboru rozpuszczalników są dostępność, najniższa możliwa toksyczność i zdolność do tworzenia termodynamicznie stabilnego roztworu wszystkich składników. W praktyce do nakładania warstwy metodą wirowania najczęściej stosuje się mieszaninę etylocelusolwu, dimetyloformamidu i acetonu. Cellosolve etylowy ma wysoką zdolność rozpuszczania w stosunku do wszystkich składników roztworu do kopiowania, zapewnia błyszczącą jednolitą warstwę, ma słaby zapach, jest mało toksyczny i jest tani. Jego zawartość w mieszaninie może wynosić 40% lub więcej.Dimetyloformamid tworzy trwałe solwaty z zastosowanymi polimerami i zapewnia otrzymanie prawdziwych roztworów przy wysokich stężeniach polimerów.Dimetyloformamid jest jednak toksyczny, dlatego jego zawartość w mieszaninie powinna być ograniczona. Do mieszaniny dodaje się aceton w celu zwiększenia szybkości odparowania rozpuszczalników, obniżenia temperatury suszenia i zmniejszenia toksyczności roztworu. Ze względu na niewystarczającą zdolność rozpuszczania jego ilość w mieszaninie nie powinna przekraczać 10-20%. Mieszanina etylocelusolwu, dimegylformamidu i acetonu spełnia również zasadę proporcji rozpuszczalników: najmniej lotny składnik (dimetyloformamid) musi być dobrym rozpuszczalnikiem, aby polimer nie wytrącał się po wyschnięciu folii.
Dimetyloformamid można zastąpić cykloheksanonem, wodorotnianem metylocelozolu, dioksanem i innymi podobnymi rozpuszczalnikami. Specjalna uwaga należy zwracać uwagę na CZYSTOŚĆ rozpuszczalników, tj. stosować wyłącznie gatunki „czyste” lub „odczynnikowe”, nie stosować rozpuszczalników technicznych, gdyż zawierają one dużą ilość zanieczyszczeń, w tym wody, pogarszają rozpuszczalność produktów diazowych i konserwację właściwości roboczych roztworów i błon światłoczułych. Zastosowanie rozpuszczalników organicznych umożliwiło stworzenie kompozycji odpowiedniej do osadzania warstwy w polu elektrycznym wysokiego napięcia. W takim przypadku mieszanina rozpuszczalników, takich jak etylocellosolve, meta-ksylen i dioksan lub cykloheksanon, meta-ksylen i dioksan, musi posiadać niezbędne właściwości elektryczne. Rozpuszczanie składników stałych zmniejsza opór objętościowy roztworów.
 Okna plastikowe i aluminiowe od producenta
Okna plastikowe i aluminiowe od producenta Sukienka wykonana z plastikowych butelek DIY plastikowe ubrania
Sukienka wykonana z plastikowych butelek DIY plastikowe ubrania Rękodzieło DIY z improwizowanych materiałów w domu
Rękodzieło DIY z improwizowanych materiałów w domu